La-FMD ALD-precursor voor toekomstige toonaangevende logica- en geheugenproducten
Zeldzame aardelementen zijn sinds de 32 nm-node in grootschalige productie voor geavanceerde logische apparaten terechtgekomen (IBM, Samsung en Globalfoundries – Chipworks 2010). Met name voor Lanthanum (La) - de eponiem van de lanthanidereeks in het periodiek systeem is geïmplementeerd als dopant in de high-k metal gate stack. Lanthanumoxide (La2O3, diëlektrische constante ~ 27) wordt bijvoorbeeld al twintig jaar onderzocht als een hoge-k gate-diëlektricum ter vervanging van conventioneel siliciumdioxide (SiO2) poortdiëlektricum in de volgende generatie transistoren in logische en dynamische random access memory's (DRAM's).

Trefwoordensegmentatie van patentaanvragen van de afgelopen 20 jaar voor Lanthanum en"Atomic Layer Deposition" [Patbase-zoekopdracht 15 november 2018]
Atomaire laagdepositie is de meest veelbelovende methode voor het laten groeien van ultradunne films van La-gebaseerde gate-diëlektrica en is daarom de afgelopen 20 jaar uitgebreid onderzocht en zijn er patentaanvragen ingediend. De R&D-inspanning is gericht op gebieden met betrekking tot diëlektrische en high-k diëlektrische toepassingen in de halfgeleiderindustrie (zie trefwoordsegmentatie hierboven). De atomaire laag-voor-laag filmgroei die wordt gefaciliteerd door zelfbeperkende oppervlaktereacties in ALD biedt atomair nauwkeurige filmdiktecontrole, goede uniformiteit over een groot oppervlak substraat en uitstekende conformiteit in het geval van structuren met een hoge aspectverhouding zoals moderne FinFET's en geheugencondensator-type pilaarstructuren. Om echter vlekkeloos te werken, zijn de ALD-precursoren nodig die specifieke eigenschappen hebben (LINK):
1. Voldoende vluchtig (ten minste ~ 0.1 Torr evenwichtsdampspanning bij een temperatuur waarbij ze niet thermisch ontbinden).
2. Snel verdampend en met een reproduceerbare snelheid (voorwaarden waaraan doorgaans wordt voldaan voor vloeibare precursors, maar niet voor vaste stoffen).
3. Niet zelfreagerend of ontbindend aan het oppervlak of in de gasfase (voor zelfbeëindigende oppervlaktereacties).
4. Zeer reactief met de andere reactant die eerder aan het oppervlak is gehecht, wat resulteert in relatief snelle kinetiek en dus lagere ALD-temperaturen en cyclustijden.
5. Vluchtige bijproducten die eenvoudig verwijderd kunnen worden ter voorbereiding op de volgende halve cyclus.
6. Niet-corrosieve bijproducten om ongelijkmatigheden door film-etsing en corrosie van het gereedschap te voorkomen.
In 2007 heeft Intel Corporation HfO opgericht2in high-k gate diëlektrische stack bij 45 nm technologieknooppunt. Echter, pure HfO2lijdt aan een laag-k interfacelaagprobleem met Si, wat lagere equivalente oxidedikte (EOT) waarden beperkt. Het kristalliseert ook gemakkelijk bij temperaturen zo laag als ~500 graden. Daarom worden amorfe diëlektrica met hoge thermische stabiliteit nog steeds gezocht voor geen intrinsieke defecten (bijv. korrelgrenzen), op voorwaarde dat ze nog steeds de voordelen van HfO bieden2, zoals een hoge diëlektrische constante, een brede bandgap en een lage lekstroom. Op lanthaan gebaseerde ternaire oxiden, zoals lanthaanscandaat (LaScO3) en lanthaanlutetiumoxide (LaLuO3), afgezet door een ALD-proces met metaalamidinaatprecursoren, vertonen naar verluidt wenselijke structurele en elektrische eigenschappen. In feite vertonen LaLuO3is potentieel het beste amorfe fasepoortdiëlektricum met diëlektrische constante k~32. Het vormt geen laag-k grensvlaklagen met Si, wat effectieve oxidedikte (EOT)-waarden < 1 nm mogelijk maakt met aanzienlijk lage lekstroom. Een andere factor die bijdraagt aan de lage lekstroom over ALD gegroeide dunne LaLuO3gate-diëlektricum is de grote band-offset (2,1 eV) ten opzichte van Si; de symmetrische geleiding en valentieband-offsets resulteren in gelijke lekstromen in elektronengestuurde NMOSFET's en gatgestuurde PMOSFET's. Het blijft amorf en vormt geen legeringen met Si of Ge na respectievelijke source/drain-activeringshechtingen.

Als een zeer recent voorbeeld van een daadwerkelijke toepassing met een hoge aspectverhouding op 300 mm wafers die alle hierboven beschreven ALD-precursorkenmerken vereisen (1 tot 6), kunnen we het artikel bekijken dat Imec presenteerde op deze beroemde IEDM-conferentie, over het gebruik van een LaSiOx-laag als dipool die in de HKMG-stapel is ingevoegd. Imec slaagde erin om de complete FinFET-front-endmodule op een "standaard" bulksilicium FinFET-module te stapelen, wat ook een goede drempelspanningsafstemming, betrouwbaarheid en lagetemperatuurprestaties demonstreerde. Vermoedelijk is het hoogstwaarschijnlijk afgezet door een ALD-proces, aangezien het de vinnen conform moet coaten en een nauwkeurige diktecontrole en uniformiteit moet garanderen: IEDM2018 Paper #7.1, "Eerste demonstratie van 3D-gestapelde FinFET's met een 45nm Fin Pitch en 110nm Gate Pitch Technology op 300mm Wafers," A. Vandooren et al, Imec.
Zoals in dit geval en nog veel meer, plaatsen de strenge kwalificaties voor ALD-precursoren ze in de categorie van hoogwaardige specialiteitschemicaliën - de prestatie- of functiespecifieke materialen of moleculen van keuze. De afgezette filmeigenschappen worden sterk beïnvloed door de fysieke en chemische eigenschappen van een enkel molecuul of een geformuleerd mengsel van moleculen, evenals de chemische samenstelling ervan. Daarom legt het veel druk op de fabrikant en leverancier van de hoogwaardige specialiteitschemicaliën in termen van kwaliteit, zuiverheid, documentatieprocedures, klantenservice, enz.
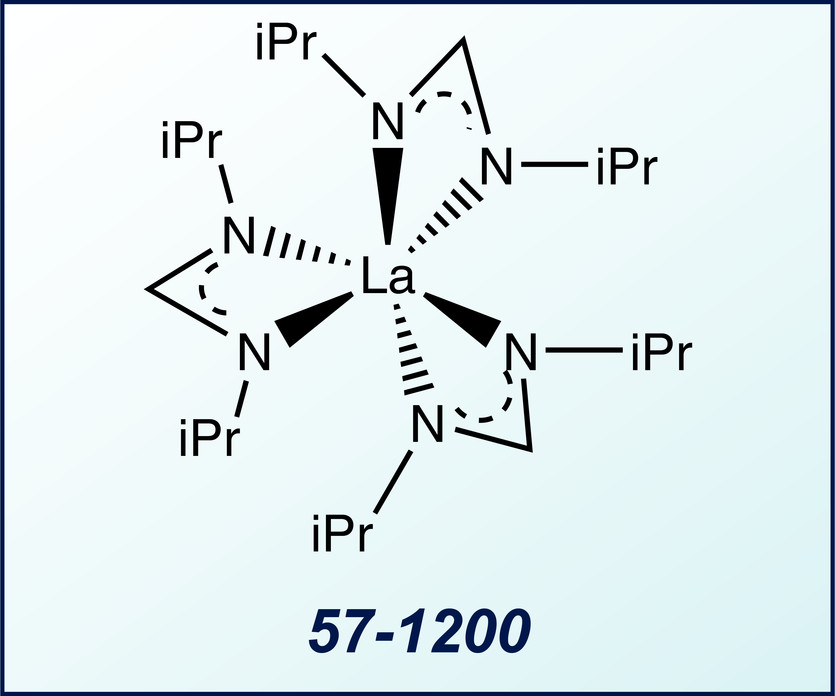
Tris(N,N'-di-i-propylformamidinato)lanthaan(III), (99.999+%-La) La-FMD is een van de metaalamidinaatprecursoren voor La ALD. Het materiaal is een wit tot gebroken wit poeder. De chemische formule en het molecuulgewicht van La-FMD zijn C21H45LAN6en 520,53, respectievelijk. Rohm and Haas Electronic Materials LLC (later Dow Chemical) meldt La-FMD als de meest vluchtige La-precursor die tot nu toe bekend is. De dampspanning bij een bepaalde temperatuur die door La-FMD wordt veroorzaakt, is hoger dan die van La(Cp)3en La(thd)3. Bovendien meldt Roy G. Gordon van Harvard University dat de amidinaatprecursoren thermisch stabieler zijn dan hun amide-tegenhangers vanwege de chelerende amidinaatligand en de afwezigheid van een MC-binding. La-amidinaten zijn zeer reactief met Si-H-bindingen, wat resulteert in een veel kortere oppervlakteverzadigingstijd en op zijn beurt een snelle zelfbeëindiging van de ALD-halfreactie; waardoor de ALD-cyclustijd wordt verkort. Ook wordt een uitstekende oppervlaktebedekking geboden door La-amidinaatprecursoren op waterstofbeëindigde Si.
Oorsprong van: https://www.strem.com/catalog/product_blog/160/1/strem_biedt_nieuwe_la-fmd_ald_voorloper_voor_toekomstige_leidende_rand_logica_en_geheugen_producten
